Obsah
Iontová implantace je nízkoteplotní proces, kterým jsou složky jednoho prvku zrychleny na pevný povrch desky, čímž se mění jeho fyzikální, chemické nebo elektrické vlastnosti. Tato metoda se používá při výrobě polovodičových zařízení a při dokončování kovů, jakož i při výzkumu vědy o materiálech. Komponenty mohou změnit elementární složení desky, pokud se zastaví a zůstanou v ní. Iontová implantace také způsobuje chemické a fyzikální změny, když se atomy srazí s cílem při vysoké energii. Krystalová struktura desky může být poškozena nebo dokonce zničena energetickými kaskádami kolizí a částice dostatečně vysoké energie (10 MeV) mohou způsobit jadernou transmutaci.
Obecný princip instalace iontové implantace

Zařízení se obvykle skládá ze zdroje, kde se tvoří atomy požadovaného prvku, urychlovače, kde se elektrostaticky zrychlují na vysokou energii, a cílové komory, kde se srazí s cílem, kterým je materiál. Tento proces je tedy zvláštním případem emise částic. Každý iont je obvykle samostatný atom nebo molekula, a tak skutečné množství materiálu implantovaného do cíle je integrálem v čase iontového proudu. Toto číslo se nazývá dávka. Proudy dodávané implantáty jsou obvykle malé (mikroampéry), a proto množství, které lze implantovat v přiměřené době, je malé. Iontová implantace proto najde uplatnění v případech, kdy je počet potřebných chemických změn malý.
Typické iontové energie se pohybují od 10 do 500 kev (1600 až 80 000 aj). Lze použít iontovou implantaci při nízkých energiích v rozmezí 1 až 10 keV (160 až 1600 aj), ale penetrace je pouze několik nanometrů nebo méně. Síla pod tím vede k velmi malému poškození cíle a zasáhne pod označením depozice iontového paprsku. A lze také použít vyšší energie: běžné jsou urychlovače schopné 5 MeV (800 000 aj). Často však dochází k velkému strukturálnímu poškození cíle a protože distribuce hloubky je široká (Braggův vrchol), čistá změna složení v kterémkoli bodě cíle bude malá.
Iontová energie, stejně jako různé druhy atomů a složení cíle, určují hloubku pronikání částic do pevné látky. Monoenergetický iontový paprsek má obvykle široké rozložení hloubky. Střední penetrace se nazývá rozsah. Za typických podmínek bude mezi 10 nanometry a 1 mikrometrem. Nízkoenergetická iontová implantace je tedy zvláště užitečná v případech, kdy je žádoucí, aby chemická nebo strukturální změna byla v blízkosti cílového povrchu. Částice postupně ztrácejí svou energii, když procházejí pevnou látkou, a to jak z náhodných kolizí s cílovými atomy( které způsobují náhlé přenosy energie), tak z lehké inhibice z překrývání elektronických orbitálů, což je kontinuální proces. Ztráta iontové energie v cíli se nazývá zastavení a může být modelována metodou iontové implantace aproximace binárních kolizí.
Systémy akcelerátoru se obvykle dělí na střední proud, vysokou, velkou energii a velmi významnou dávku.
Všechny druhy konstrukcí iontových implantačních paprsků obsahují určité společné skupiny funkčních složek. Zvažte příklady. První fyzikální a fyzikálně-chemické základy iontové implantace zahrnují zařízení známé jako zdroj pro generování částic. Toto zařízení je úzce spojeno s předpjatými elektrodami pro extrakci atomů do linie paprsku a nejčastěji s některými prostředky pro výběr konkrétních druhů pro transport do hlavní sekce urychlovače. Volba "hmoty" je často doprovázena průchodem odvozeného iontového paprsku přes oblast magnetického pole s výstupní cestou omezenou blokovacími otvory nebo "štěrbinami", které umožňují pouze ionty s určitou hodnotou produktu hmoty a rychlosti. Pokud je cílový povrch větší než průměr iontového paprsku a je žádoucí, aby byla implantovaná dávka rovnoměrně rozložena, použije se nějaká kombinace skenování paprsku a pohybu desky. Nakonec je cíl spojen s určitým způsobem sběru uloženého náboje implantovaných iontů, takže dodaná dávka může být měřena kontinuálním způsobem a proces se zastaví na požadované úrovni.
Aplikace ve výrobě polovodičových zařízení
Doping boru, fosforu nebo arsenu je běžnou aplikací tohoto procesu. Při iontové implantaci polovodičů může každý dopantový Atom po žíhání vytvořit nosič náboje. Můžete postavit díru pro dopant typu P a elektron typu n. To mění vodivost polovodiče v jeho okolí. Tato technika se používá například k úpravě prahu MOSFET.
Iontová implantace byla vyvinuta jako metoda pro získání PN přechodu fotovoltaických zařízení koncem 70. a počátkem 80. let spolu s použitím pulzního elektronového paprsku pro rychlé žíhání, ačkoli dosud nebyla použita pro komerční výrobu.
Křemík na izolátoru

Jedním ze známých způsobů výroby daného materiálu na dielektrických substrátech (SOI) z konvenčních křemíkových substrátů je proces SIMOX (separace pomocí implantace kyslíku), ve kterém je naplněný vzduch s vysokou dávkou přeměněn na oxid křemičitý procesem vysokoteplotního žíhání.
Mezotaxie
Toto je termín pro růst krystalograficky shodné fáze pod povrchem základního krystalu. V tomto procesu jsou ionty implantovány s dostatečně vysokou energií a dávkou do materiálu, aby se vytvořila vrstva druhé fáze, a teplota je regulována tak, aby se struktura cíle nerozpadla. Krystalová orientace vrstvy může být navržena tak, aby odpovídala cíli, i když přesná mřížková konstanta se může velmi lišit. Například po implantaci niklových iontů do křemíkové destičky lze pěstovat silicidovou vrstvu, ve které se orientace krystalů shoduje s hodnotami křemíku.
Aplikace v kovovém provedení

Dusík nebo jiné ionty mohou být implantovány do terče z nástrojové oceli (např. Strukturální změna vyvolává povrchovou kompresi v materiálu, což zabraňuje šíření trhlin, a proto je odolnější vůči rozbití.
Povrchová úprava

V některých aplikacích, například u protéz, jako jsou umělé klouby, je žádoucí mít cíl velmi odolný vůči chemické korozi a opotřebení způsobené třením. Iontová implantace se používá k navrhování povrchů takových zařízení pro více spolehlivý provoz. Stejně jako u nástrojových ocelí zahrnuje modifikace cíle způsobená iontovou implantací jak povrchovou kompresi, která zabraňuje šíření trhlin, tak doping, aby byla chemicky odolnější vůči korozi.
Další aplikace

Implantace může být použita k dosažení míchání iontových paprsků, tj. To může být užitečný pro dosažení odstupňovaných povrchů nebo zvýšení adheze mezi vrstvami nemísitelných materiálů.
Tvorba nanočástic
Iontová implantace může být použita k indukci nanoměřítkových materiálů v oxidech, jako je safír a oxid křemičitý. Atomy mohou být vytvořeny srážením nebo tvorbou směsných látek, které obsahují jak iontově implantovaný prvek, tak substrát.
Typické energie iontového paprsku používané k výrobě nanočástic se pohybují mezi 50 a 150 kev a iontová tekutina se pohybuje mezi 10-16 a 10-18 KV. cm. Může být vytvořena široká škála materiálů o rozměrech od 1 nm do 20 nm as kompozicemi, které mohou obsahovat implantované částice, kombinace, které se skládají výhradně z kationtu vázaného na substrát.
Slibné jsou látky na bázi dielektrik, jako je safír, které obsahují dispergované nanočástice iontové implantace kovů materiály pro optoelektronika a nelineární optika.
Problémy
Každý jednotlivý iont produkuje mnoho bodových defektů v cílovém krystalu při nárazu nebo vložení. Volná místa jsou mřížkové body, které nejsou obsazeny atomem: v tomto případě se ion srazí s cílovým atomem, což vede k přenosu významného množství energie na něj, takže opouští svůj pozemek. Tento cílový objekt se sám stává projektilem v pevné látce a může způsobit následné srážky. Internody se vyskytují, když se takové částice zastaví v pevné látce, ale nenajdou volné místo v mřížce k pobytu. Tyto bodové defekty v iontové implantaci mohou migrovat a shlukovat se navzájem, což vede k dislokačním smyčkám a dalším problémům.
Amorfizace
Množství krystalografického poškození může být dostatečné k úplnému přechodu cílového povrchu, to znamená, že se musí stát amorfní pevnou látkou. V některých případech je úplná amorfizace cíle výhodnější než krystal s vysokým stupněm defektu: takový film může znovu růst při nižší teplotě, než je požadováno pro žíhání vysoce poškozeného krystalu. K amorfizaci substrátu může dojít změnou paprsku. Například při implantaci yttriových iontů do safíru při energii paprsku 150 kev na fluenci 5*10-16 y + / KV. cm se vytvoří sklovitá vrstva o tloušťce přibližně 110 nm, měřená z vnějšího povrchu.
Naprašování

Některé z kolizních událostí způsobují, že atomy jsou vyhozeny z povrchu, a tak iontová implantace pomalu leptá povrch. Účinek je patrný pouze u velmi velkých dávek.
Iontový kanál

Pokud je na cíl aplikována krystalografická struktura, zejména v polovodičových substrátech, kde je otevřenější, pak se konkrétní směry zastaví mnohem méně než ostatní. Výsledkem je, že dosah iontu může být mnohem větší, pokud se pohybuje přesně podél určité stopy, například v křemíku a jiných diamantových kubických materiálech. Tento účinek se nazývá iontové kanalizace a stejně jako všechny podobné účinky jsou vysoce nelineární, s malými odchylkami od ideální orientace, což vede k významným rozdílům v hloubce implantace. Z tohoto důvodu se většina provádí o několik stupňů mimo osu, kde drobné chyby zarovnání budou mít předvídatelnější účinky.
 Schéma dac. Digitálně-analogové převodníky: typy, klasifikace, pracovní princip, účel
Schéma dac. Digitálně-analogové převodníky: typy, klasifikace, pracovní princip, účel Elektromagnetický pohon: typy, účel, pracovní princip
Elektromagnetický pohon: typy, účel, pracovní princip Parní formalínová komora: pracovní princip, aplikace, instrukce
Parní formalínová komora: pracovní princip, aplikace, instrukce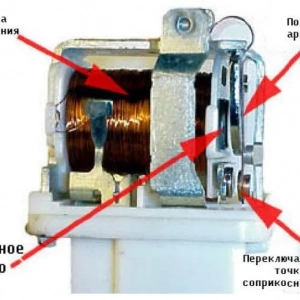 Relé: typy, klasifikace, účel a pracovní princip
Relé: typy, klasifikace, účel a pracovní princip Magnetohydrodynamický generátor: zařízení, pracovní princip a účel
Magnetohydrodynamický generátor: zařízení, pracovní princip a účel Magnetická anténa: zařízení, pracovní princip, účel
Magnetická anténa: zařízení, pracovní princip, účel Plynoměry: pracovní princip, vlastnosti a fotografie
Plynoměry: pracovní princip, vlastnosti a fotografie Stedikam je... Popis, aplikace, pracovní princip
Stedikam je... Popis, aplikace, pracovní princip Javascript websocket: popis, pracovní princip, aplikace
Javascript websocket: popis, pracovní princip, aplikace